特長
- SEMカラムとFIBカラムを直角に配置することで、三次元構造解析に最適なカラムレイアウトを実現
- 高輝度冷陰極電界放出形電子銃と高感度検出系の組み合わせにより磁性材料から生物組織まで、さまざまな試料の解析をサポート
- 定評あるマイクロサンプリング®*とトリプルビーム®システム*により、TEMやアトムプローブの高品位試料作製にも対応
本来の試料構造を忠実に反映する、垂直入射断面SEM観察
SEMカラムとFIBカラムを直角に配置することで、FIB加工断面の垂直入射SEM観察を実現。
従来のFIB-SEMの傾斜断面観察では避けられなかった、断面SEM像の縮みや連続画像収集時の視野逃げを回避。
本来の構造に忠実な画像が安定して得られることから、精度の高い三次元構造解析を実現。
また、FIB加工断面(SEM観察断面)が試料表面と平行になるため、光学顕微鏡画像などとの相関をとるうえでも有利。
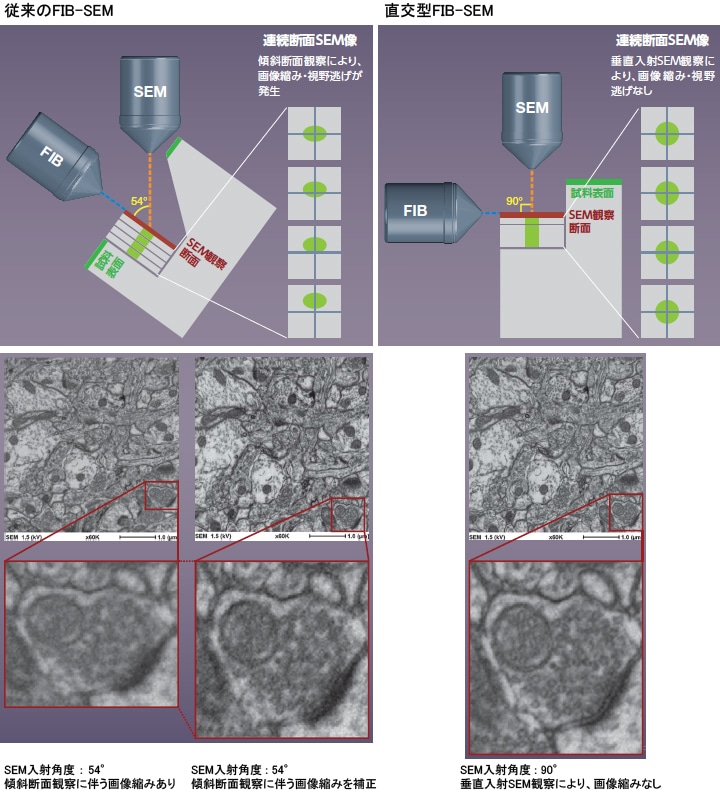
試料:マウス脳神経細胞
試料ご提供:自然科学研究機構・生理学研究所 窪田 芳之 様
さまざまな材料に対応する、Cut&See®・3D-EDS*1・3D-EBSD*1
Cut&See®
生物組織や半導体から鉄鋼やニッケルなどの磁性材料まで、低加速電圧での高分解能・高コントラスト観察に対応。
FIB加工とSEM観察の間の装置条件の変更も不要で、高スループットで連続断面シリーズ像を収集可能。
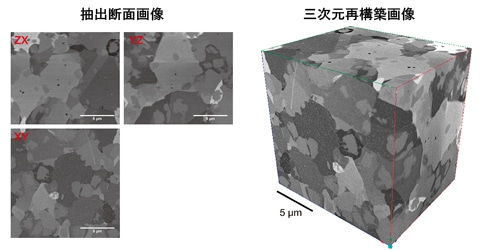
試料:ニッケル
SEM加速電圧:1 kV
加工ステップ:20 nm
繰り返し回数:675回
Cut&Seeは株式会社日立ハイテクの国内における登録商標です。
3D-EDS*1
断面SEM像だけでなく、断面元素マップの連続シリーズ収集にも対応。
シリコンドリフト式大立体角EDS検出器*1と組み合わせることで、測定時間の短縮・低加速電圧での元素マッピングも可能。

試料:燃料電池電極
SEM加速電圧:5 kV
加工ステップ:100 nm
繰り返し回数:212回
試料ご提供:東京大学 生産技術研究所 教授 鹿園直毅様
3D-EBSD*1
SEM・FIB・EBSD検出器*1の最適配置により、FIB加工とEBSD分析の間でステージを移動することなく3D-EBSDを実現。ステージ移動を伴わないことから、三次元結晶方位解析の精度・スループットを大幅に向上。

試料:ニッケル
SEM加速電圧:20 kV
加工ステップ:150 nm
繰り返し回数:150回
- *1:
- オプション
- * 「マイクロサンプリング」は、株式会社日立ハイテクの日本国内における登録商標です(登録商標第4399203号)。
「トリプルビーム」は、株式会社日立ハイテクサイエンスの日本国内における登録商標です(登録商標第5136729号)。この記載内容は2015年5月現在のものです。